Flip-Chip-Maschinen für die Montage von Facing-Down-Chips/Dies
Unsere lasergestützten Klebeanlagen für Flip-Chips bieten eine Reihe von Vorteilen, die die üblichen Herausforderungen bei Verbindungsprozessen angehen. Mit unserer Technologie können wir das Problem des thermischen Stresses, der durch lange Reflow-Zeiten verursacht wird und sich negativ auf die Zuverlässigkeit und Leistung der Geräte auswirken kann, wirksam angehen. Durch den Einsatz unserer Maschinen können wir die thermische Belastung verringern und sicherstellen, dass die Komponenten in der Umgebung der Klebestelle nicht durch übermäßige Hitze beeinträchtigt werden. Dies ist von entscheidender Bedeutung, um die Integrität des Geräts zu erhalten und mögliche Schäden oder Fehlfunktionen zu vermeiden.
Während sich unsere lasergestützten Klebemaschinen auf die Abschwächung der thermischen Belastung konzentrieren, ist es wichtig zu erwähnen, dass das Flip-Chip-Bonden selbst eine Reihe von Vorteilen gegenüber anderen Verbindungsprozessen bietet. Ein wesentlicher Vorteil ist die Möglichkeit, eine höhere Anzahl von Ein- und Ausgängen (E/A) zu erreichen. Im Gegensatz zu anderen Verfahren wird beim Flip-Chip-Bonden die gesamte Fläche des Chips für Verbindungen genutzt. Dies bedeutet, dass mehr Verbindungen hergestellt werden können, was zu einer erhöhten Funktionalität und verbesserten Leistung des Geräts führt.
Neben der höheren E/A-Zahl bietet das Flip-Chip-Bonden auch eine höhere Geschwindigkeit im Vergleich zum Drahtbonden. Durch die Verwendung kürzerer Verbindungswege wird die Signalübertragung innerhalb des Geräts optimiert. Dies führt zu einer höheren Geschwindigkeit und Gesamteffizienz des Geräts. Die kürzere Strecke, die die Signale zurücklegen müssen, trägt zu einem schnelleren Betrieb und besseren Reaktionszeiten bei.
Darüber hinaus bietet das Flip-Chip-Bonden im Vergleich zum Draht-Bonden einen kleineren Formfaktor. Durch den Wegfall der Drahtbondschleifen kann die Gesamtgröße des Geräts erheblich reduziert werden. Dies ermöglicht eine kompaktere Bauweise und die Integration von mehr Komponenten auf begrenztem Raum.
Zusammenfassend lässt sich sagen, dass unsere lasergestützten Klebeanlagen für Flip-Chips die besondere Herausforderung von thermischen Spannungen und Wärmeeffekten bei Verbindungsprozessen meistern. Es ist jedoch wichtig zu erkennen, dass das Flip-Chip-Bonding insgesamt eine Reihe von Vorteilen bietet, darunter eine höhere E/A-Anzahl, eine höhere Geschwindigkeit und ein kleinerer Formfaktor. Diese Vorteile tragen gemeinsam dazu bei, die Leistung, Funktionalität und Kompaktheit von elektronischen Geräten zu verbessern.
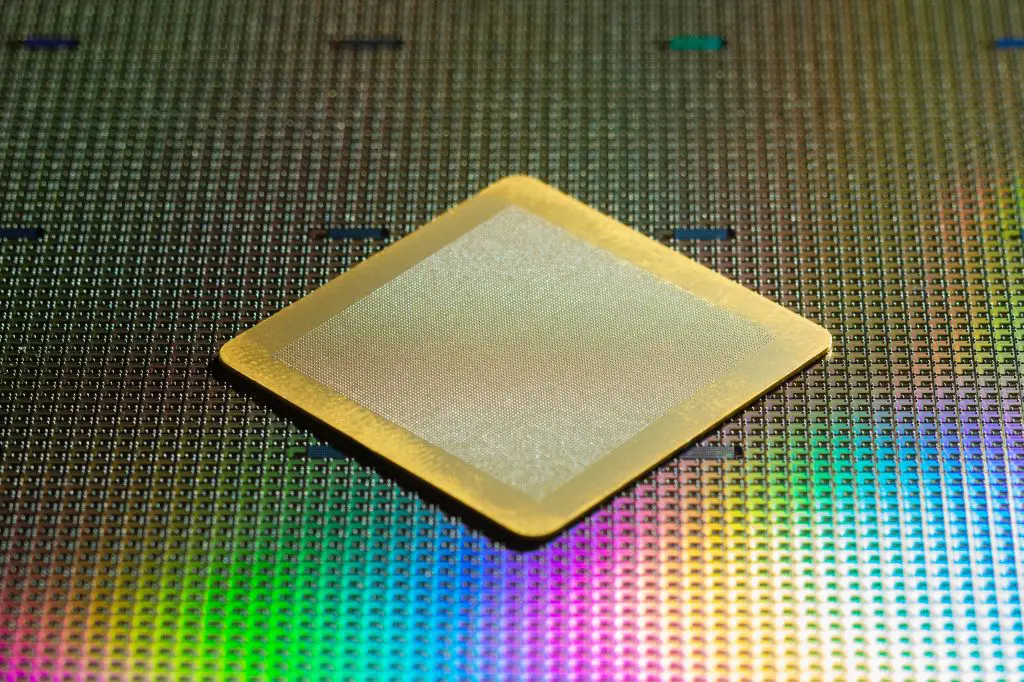
Flip-Chip-Maschinen
LAPLACE ® – 3.5D ®
Die LAPLACE® – 3.5D® Laser-Gestützte Bonding-Plattform ist unsere Lösung für die Ultrafein-Pitch-Cantilever-Montage auf Wafer-Probekarten mit optionaler Nacharbeitsfunktion.
SB² ® – Jet
Die SB² ® - Jet bietet die höchste Bestückungspräzision aller PacTech-Maschinen und ist in der Lage, die kleinsten Lotkugeln im Portfolio zu verarbeiten.
PACLINE ®
Die PACLINE ® ist eine vollautomatische Anlage zur stromlosen Abscheidung von Ni/Au-, NiPd- oder NiPdAu-Bumps auf Halbleiterwafern.
LAPLACE ® – HT
Die LAPLACE ® - HT ist eine automatische Laserlötanlage für die Montage von z.B. Schottky- und Bypass-Dioden - speziell für Solarzellenmodule.
LAPLACE ® – LAB 300A
Die LAPLACE ® - LAB 300A -Maschine bietet eine integrierte Lösung für die Flip-Chip-Bestückung für laserunterstütztes Löten, ACF und NCP-Verbindungen.
LAPLACE ® – LAR 600A
Die LAPLACE ® LAR 600A revolutioniert das Reflow-Löten mit lasergestützter Technologie und bietet schnellere Reflow-Zeiten, geringere thermische Belastung und verbesserte Effizienz für eine Vielzahl von Anwendungen bei gleichzeitiger Minimierung von Energieverbrauch und CO₂-Emissionen.
SB² ® – Compact
Die SB² ® – Compact-Maschine ist der SB² ® -Einstieg in die Großserienproduktion mit hochflexibler und ultrakompakter Arbeitsstation.
LAPLACE ® – LAB 600A
Laser Bonding System (LAB) mit Kompressions-Bonding und Laserunterstütztem Reflow.
SB² ® – SM
Die SB² ® - SM ist eine Maschine für das Prototyping und Kleinserienfertigung, mit größerem Arbeitsbereich und mehr Funktionen als die SB² ® - M .
Ultra-SB² ®
Ultra-SB² ® ist eine vollautomatische Lötbumping-Maschine, die Flussmitteldruck, Ball-Placement, 2D-Inspektion und Rework integriert.