用于各种金属镀层的化镀机
化镀机
在半导体行业中,化镀工艺用于处理焊盘表面。这种焊盘处理过程具有多种优势,例如可焊性、可靠性等。根据焊盘材料和后端工艺的不同,需要适当选择镀金属层的成分。例如:
模块化湿法设备
该模块化湿法设备是一种紧凑且灵活的湿法处理系统,适用于晶圆和面板的电镀、蚀刻、剥离及清洗工艺。该系统基于单一工艺模块设计,配备两个串联排列的槽体及侧置控制柜。 工艺模块内的触控显示屏以及可移动中央触控显示器,可快速访问状态信息和工艺配方。
在人工上料后,全自动集成机械臂负责在两个工艺槽之间前后搬送载具,并执行槽内搅拌。清晰且功能性的设计便于维护和保养。 由控制柜和一个工艺模块组成的基础单元,可通过增加工艺模块实现灵活且无限扩展。
PacTech 是拥有超过 25 年丰富经验的半导体晶圆化镀综合解决方案提供商。我们将根据您的需求提供各种方案。


晶圆级封装服务(WLP服务)
作为一项入门级生产服务,我们可以提供适用以下场景的代工服务/晶圆级封装服务: 无需巨额投资的量产、小批量生产、研发和备源。

化镀生产线和化镀化学品
为您的工厂实现批量生产,我们提供全自动化镀生产线 / PACLINE ® 以及我们的化镀化学品。

一站式解决方案
如果您开始使用我们的晶圆级封装服务进行小规模生产,并购买我们的设备和化学品,您可以通过我们提出的一站式解决方案顺利过渡到您自己工厂的大规模生产。当您安装设备时,我们将为您提供包括工艺配方和操作培训在内的配套。
化镀镍/金概述
凸块下金属化层 (Under-Bump-Metallization, UBM) 是所有凸点工艺的重要组成部分。
该层通常通过物理气相沉积 (PVD)、电镀或化镀沉积。 这三种 UBM 技术的选择通常取决于成本和可靠性。 PVD 和电镀技术都需要高真空和光刻步骤,因此被认为是高成本操作。 化镀镍/金工艺技术是一种简单的湿化学工艺,具有自模板的特点,因此与总投资和运营成本相比,具有更低的成本优势。
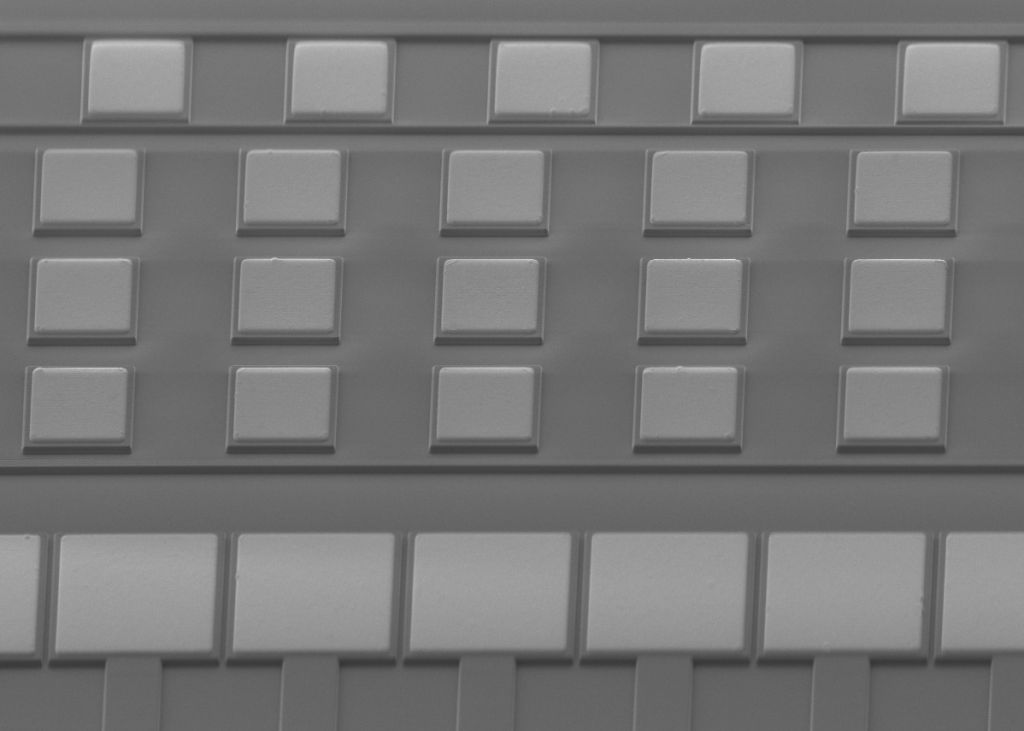
铜基半导体上的化镀
对于铜基的半导体,镍和金的镀液与铝基的半导体相同。通常会使用几个酸性清洁步骤来清除杂质,并从I/O电路板表面去除铜氧化物。铜的活化步骤类似于层压板镀层行业中使用的步骤,通常使用基于钯的催化剂。镀铜半导体的专业知识在于能够有选择性地催化铜I/O电路板,而不激活周围的保护层。
这些化镀过程本质上成本较低,并且除了倒装芯片和晶圆级芯片级封装凸块之外,还可以用于各种不同的应用,包括:
通过化镀生产线批量处理晶圆盒,可实现高通量,从而降低成本。镀镍过程具有高度选择性,只会在暴露的金属表面(铝或铜)上镀层,为这种UBM沉积技术带来了重大的成本优势。与用于沉积UBM的传统技术相比,使用化镀镍具有以下优势:
化镀工艺应用于集成电路领域也并非易事,这主要是因为制造电路所涉及的材料和工艺会因晶圆厂而异。铝 (或铜) 合金成分、焊盘金属下方的微观结构、钝化层材料及其质量、焊盘电势以及能量敏感性 (辐射和接地效应) 都将影响镀镍速度、均匀性和镍与铝 (或铜) 焊盘的附着力。
由于工艺细节 (行业内部诀窍) 通常不被视为可专利化,因此工艺开发者会将他们的工艺视为专有技术。因此,有关化镀镍层的详细信息并不容易获得。
工艺过程中的前三个步骤对于确定镀层过程的整体选择性、镍的形貌以及镍与铝 (或铜) 焊盘的附着力至关重要。通常,能够生成细颗粒、均匀、薄的催化剂 (锌或钯) 层的工艺将产生最佳的镀镍结构。特定的化学成分和绝对成分比例对于生产这种所需的结构至关重要。在制造环境中实施工艺时,除了选择合适的化镀化学成分之外,还必须考虑化学品的可用性、产地、价格、毒理学、槽寿命、废物处理/处置以及环境问题。
化镀设备
PACLINE ®
PACLINE ® 300 A50是一台全自动机器,用于在半导体晶圆上进行化镀Ni/Au、NiPd或NiPdAu凸点沉积。


