LAPLACE ® – 3.5D ® 激光辅助键合平台是我们针对晶圆探针卡超细间距悬臂组装的解决方案,并可选配返修功能。此外,该系统专为芯片及其他半导体器件的垂直贴装而设计,可扩展传统3D芯片封装,并提升异构集成的设计灵活性。超短脉冲激光加热,实现适用于复杂垂直互连结构的低应力键合。
该系统采用独特的专利激光热压头工具,并集成于键合设备的真空取放单元中。
亮点
贴装精度:≤ ±3µm
基板尺寸最大可达13英寸
高度控制精度:≤ 5µm
悬臂厚度:20–100µm
芯片厚度:最小60µm
间距:最小60µm(悬臂)
全流程控制
通过定位键合实现对准控制
选项
通过重新定位或更换进行修复
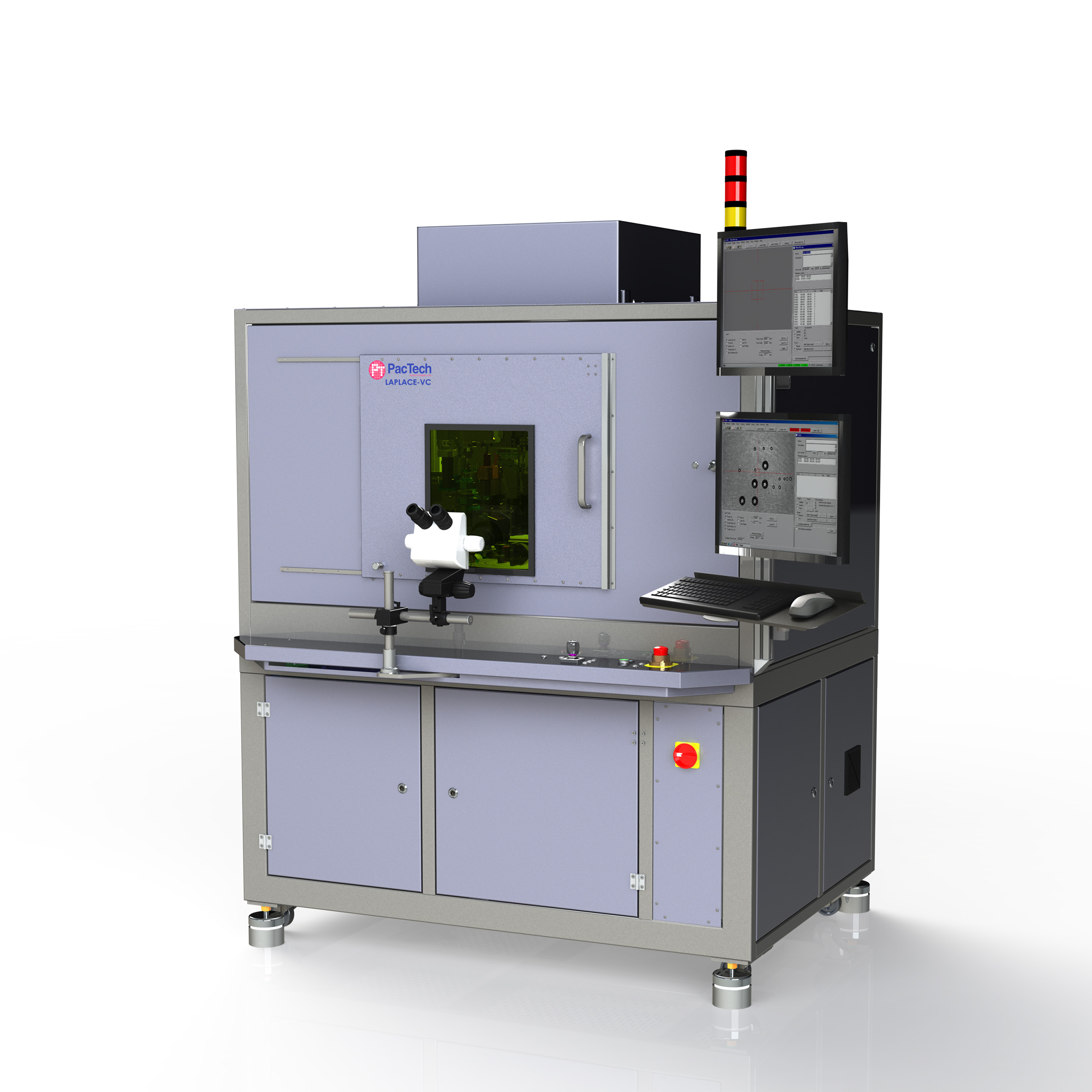
动态随机存取存储器 (DRAM)
闪存
NAND闪存
垂直芯片键合
悬臂组装
晶圆探针卡

