用于組裝面朝下芯片/模具的倒裝芯片鍵合機
我們的激光輔助鍵合機為倒裝芯片提供了一系列優勢,解決了互連過程中常見的挑戰。傳統回流焊工藝會導致較長的加熱時間,進而産生熱應力,對器件的可靠性和性能産生負面影響。
通過我們的技術,我們可以有效解決長時間回流引起的熱應力問題。通過使用我們的機器,我們可以降低熱應力,並確保鍵合區域周圍的組件不受過熱的影響。這對于保持設備的完整性並防止任何潛在的損壞或故障至關重要。
需要注意的是,雖然激光輔助鍵合機主要用于降低熱應力,但倒裝芯片鍵合本身相對于其他互連過程提供了一系列優勢。一個顯著的優勢是能夠實現更高的輸入/輸出(I/O)計數。與其他過程不同,倒裝芯片鍵合利用整個晶片區域進行連接。這意味著可以進行更多的連接,從而增加了器件的功能和性能。
除了更高的I/O計數外,倒裝芯片鍵合與引線鍵合相比還具有更快的速度。通過利用較短的互連路徑,器件內部的信號傳輸得以優化。 這帶來了更快的速度和更高的器件整體效率。信號傳輸距離的縮短有助于器件更快地運行並改善響應時間。
此外,與引線鍵合相比,倒裝芯片鍵合藝還可以實現更小的外形尺寸。通過消除引線鍵合環,可以顯著減小器件的整體尺寸。這使得設計更加緊湊,並且能夠在有限的空間內集成更多組件。
綜上所述,我們的激光輔助倒裝芯片鍵合機針對互連過程中的特定熱應力和熱效應挑戰提供了解決方案。然而,更重要的是,倒裝芯片鍵合本身就具備諸多優點,包括更高的I/O計數、更快的速度和更小的外形尺寸。這些優勢共同促進了電子器件的性能、功能和緊湊性的提升。
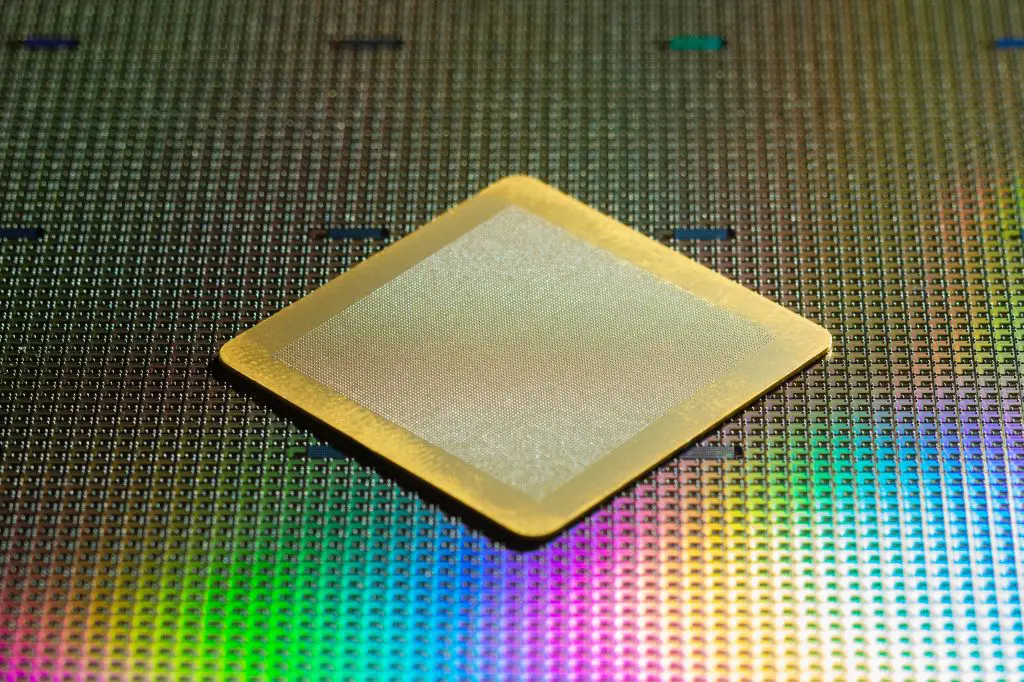
倒裝芯片設備
LAPLACE ® – 3.5D ®
LAPLACE®–3.5D® 雷射輔助鍵合平台是我們針對晶圓探針卡超細間距懸臂組裝的解決方案,並可選配重工功能。
LAPLACE ® – HT
LAPLACE ® - HT是一台自動激光焊接機,用于組裝例如肖特基和旁路二極管--特別是用于太陽能電池模塊。
PACLINE ®
PACLINE ® 300 A50是一台全自動機器,用于在半導體晶圓上進行化鍍Ni/Au、NiPd或NiPdAu凸點沈積。
SB² ® – Compact
SB² ® – Compact 機器是SB² ® 大批量生産的切入點,具有高度靈活和超緊湊的工作站。
LAPLACE ® – LAB 300A
LAPLACE ® - LAB 300A 機器為激光輔助焊接、ACF和NCP互連的倒裝芯片組裝提供了一個綜合解決方案。
LAPLACE ® – LAR 600A
LAPLACE ® LAR 600A 為各種應用提供了更快的回流時間和更低的熱應力, 同時最大限度地減少能源消耗和二氧化碳排放量。
SB² ® – SM
SB² ® - SM 是一台用于原型設計和小批量生産的機器,它比SB² ® - M 有更寬的工作區域和更多的可選功能。