用于各種金屬鍍層的化鍍機
化鍍機
在半導體行業中,化鍍工藝用于處理焊盤表面。這種焊盤處理過程具有多種優勢,例如可焊性、可靠性等。根據焊盤材料和後端工藝的不同,需要適當選擇鍍金屬層的成分。例如:
模組化濕製程設備
此模組化濕製程設備為一種精巧且靈活的系統,適用於晶圓與面板之電鍍、蝕刻、剝離與清洗製程。本系統以單一製程模組為基礎,配備兩個串聯式槽體及側掛式控制櫃。 製程模組內建觸控顯示器,並配有可移動式中央觸控螢幕,可快速存取狀態資訊與製程配方。
手動上料後,全自動整合式機械手臂負責於兩個製程槽間前後搬運載具,並進行槽內攪拌。清晰且功能導向的設計,便於維護與保養。由控制櫃與一個製程模組組成之基本單元,可透過增加製程模組彈性且無限制擴充。
PacTech 是擁有超過 25 年豐富經驗的半導體晶圓化鍍綜合解決方案提供商。我們將根據您的需求提供各種方案。


晶圓級封裝服務(WLP服務)
作為一項入門級生産服務,我們可以提供適用以下場景的代工服務/晶圓級封裝服務: 無需巨額投資的量産、小批量生産、研發和備源。

化鍍生産線和化鍍化學品
為您的工廠實現批量生産,我們提供全自動化鍍生産線 / PACLINE ® 以及我們的化鍍化學品。

一站式解決方案
如果您開始使用我們的晶圓級封裝服務進行小規模生産,並購買我們的設備和化學品,您可以通過我們提出的一站式解決方案順利過渡到您自己工廠的大規模生産。當您安裝設備時,我們將為您提供包括工藝配方和操作培訓在內的配套。
化鍍鎳/金概述
凸塊下金屬化層 (Under-Bump-Metallization, UBM) 是所有凸點工藝的重要組成部分。
該層通常通過物理氣相沈積 (PVD)、電鍍或化鍍沈積。 這三種 UBM 技術的選擇通常取決于成本和可靠性。 PVD 和電鍍技術都需要高真空和光刻步驟,因此被認為是高成本操作。 化鍍鎳/金工藝技術是一種簡單的濕化學工藝,具有自模板的特點,因此與總投資和運營成本相比,具有更低的成本優勢。
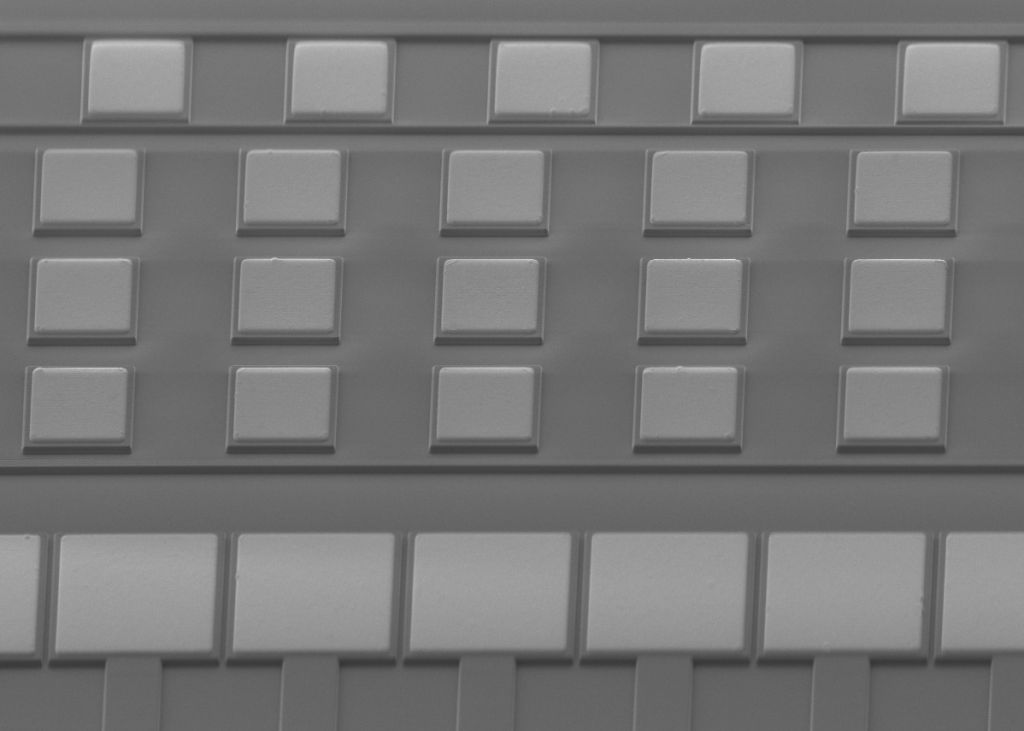
銅基半導體上的化鍍
對于銅基的半導體,鎳和金的鍍液與鋁基的半導體相同。通常會使用幾個酸性清潔步驟來清除雜質,並從I/O電路板表面去除銅氧化物。銅的活化步驟類似于層壓板鍍層行業中使用的步驟,通常使用基于钯的催化劑。鍍銅半導體的專業知識在于能夠有選擇性地催化銅I/O電路板,而不激活周圍的保護層。
這些化鍍過程本質上成本較低,並且除了倒裝芯片和晶圓級芯片級封裝凸塊之外,還可以用于各種不同的應用,包括:
通過化鍍生産線批量處理晶圓盒,可實現高通量,從而降低成本。鍍鎳過程具有高度選擇性,只會在暴露的金屬表面(鋁或銅)上鍍層,為這種UBM沈積技術帶來了重大的成本優勢。與用于沈積UBM的傳統技術相比,使用化鍍鎳具有以下優勢:
化鍍工藝應用于集成電路領域也並非易事,這主要是因為制造電路所涉及的材料和工藝會因晶圓廠而異。鋁 (或銅) 合金成分、焊盤金屬下方的微觀結構、鈍化層材料及其質量、焊盤電勢以及能量敏感性 (輻射和接地效應) 都將影響鍍鎳速度、均勻性和鎳與鋁 (或銅) 焊盤的附著力。
由于工藝細節 (行業內部訣竅) 通常不被視為可專利化,因此工藝開發者會將他們的工藝視為專有技術。因此,有關化鍍鎳層的詳細信息並不容易獲得。
工藝過程中的前三個步驟對于確定鍍層過程的整體選擇性、鎳的形貌以及鎳與鋁 (或銅) 焊盤的附著力至關重要。通常,能夠生成細顆粒、均勻、薄的催化劑 (鋅或钯) 層的工藝將産生最佳的鍍鎳結構。特定的化學成分和絕對成分比例對于生産這種所需的結構至關重要。在制造環境中實施工藝時,除了選擇合適的化鍍化學成分之外,還必須考慮化學品的可用性、産地、價格、毒理學、槽壽命、廢物處理/處置以及環境問題。
化鍍設備
PACLINE ®
PACLINE ® 300 A50是一台全自動機器,用于在半導體晶圓上進行化鍍Ni/Au、NiPd或NiPdAu凸點沈積。


