플립 칩 설비 — 칩/다이를 아래로 향하게 패키징
플립 칩용 레이저 본딩 설비는 칩과 기판을 연결하는 과정에서 흔히 발생하는 어려움들을 해결할 수 있는 다양한 이점을 지니고 있습니다. 레이저를 사용하면 패키징하는 제품이 장시간 리플로우로 인해 받는 열 스트레스 문제를 효과적으로 해결할 수 있으며, 이는 제품의 신뢰성과 성능과도 연관된 문제입니다. PacTech의 솔루션은 열 스트레스를 줄일 수 있으며, 접합 부위 주변의 기판이나 부품들이 과도한 열로 인해 영향을 받지 않도록 보장합니다. 이는 패키징 제품의 완전성을 유지하고 잠재적인 손상이나 오작동을 방지하는 데 매우 중요합니다.
PacTech의 레이저 본딩 기술은 열 스트레스의 최소화에 중점을 두고 있지만, 다른 연결 공정과 비교할 때 플립 칩 본딩 자체가 가지는 장점들도 주목할 필요가 있습니다. 플립 칩 본딩의 주요 장점 중 하나는 더 높은 입출력(I/O) 수를 구현할 수 있다는 점입니다. 다른 공정들과 달리, 플립 칩 본딩은 다이 전체 면적을 연결에 활용할 수 있습니다. 이는 더 많은 연결을 가능하게 하여, 디바이스의 기능성과 성능을 향상시킨다는 것을 의미합니다.
더 높은 I/O 수 외에도, 플립칩 본딩은 와이어 본딩에 비해 빠른 통신속도를 제공합니다. 짧은 인터커넥션 경로를 활용함으로써, 장치 내의 신호 전송이 최적화됩니다. 이로 인해 속도가 향상되고 전반적인 장치 효율이 증가합니다. 신호가 이동해야 하는 거리가 줄어들기 때문에 작동 속도가 빨라지고 반응 시간이 개선됩니다.
또한, 플립칩 본딩은 와이어 본딩에 비해 더 작은 폼팩터를 제공합니다. 와이어 본딩 루프가 필요하지 않기 때문에, 디바이스의 전체 크기를 크게 줄일 수 있습니다. 이로 인해 보다 컴팩트한 설계가 가능해지며, 제한된 공간 내에 더 많은 부품을 통합할 수 있습니다.
결론적으로, 당사의 플립 칩용 레이저 보조 본딩 장비는 인터커넥션 공정에서 발생하는 열 스트레스와 열 영향 문제를 효과적으로 해결합니다. 하지만 플립 칩 본딩 자체가 더 높은 입출력(I/O) 수, 향상된 속도, 그리고 더 작은 폼팩터 등 다양한 장점을 제공한다는 점도 중요합니다. 이러한 장점들은 전자 장치의 성능, 기능성 및 소형화를 종합적으로 향상시키는 데 기여합니다.
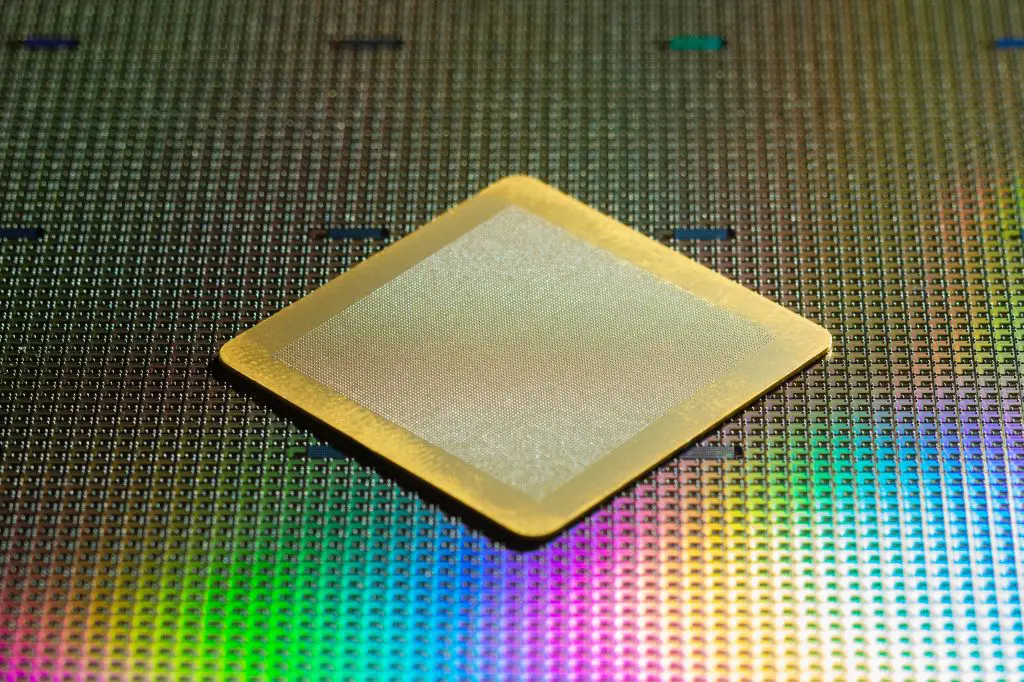
플립 칩 본딩 설비
PACLINE ®
PACLINE ® 300 A50는 반도체 웨이퍼에 Ni/Au, NiPd 또는 NiPdAu 범프를 무전해 증착하기 위한 완전 자동화 설비입니다.
LAPLACE ® – 3.5D ®
LAPLACE ® - 3.5D® 레이저 보조 본딩 플랫폼은 웨이퍼 프로브 카드의 초미세 피치 캔틸레버 조립을 위한 솔루션으로, 리워크 옵션을 제공합니다.
SB² ® – Compact
SB² ® - Compact 장비는 고도로 유연하고 초소형 워크스테이션을 갖춘 대량 생산용 SB² ® 시리즈의 입문형 설비입니다.
LAPLACE ® – LAB 600A
압착 본딩과 레이저 어시스트 리플로우를 지원하는 레이저 본딩 시스템(LAB)
Ultra-SB² ®
Ultra-SB² ® 는 플럭스 프린팅, 볼 마운팅, 2D 검사 및 웨이퍼 레벨 리웍를 통합한 완전 자동화 솔더 범핑 설비입니다.
SB² ® – Jet
SB² ® - Jet은 PacTech의 SB² ® 시리즈 중 가장 높은 배치 정밀도를 제공하며, 가장 작은 솔더 볼까지 처리할 수 있습니다.
LAPLACE ® – HT
LAPLACE ® - HT는 쇼트키 다이오드 및 바이패스 다이오드와 같은 부품 조립을 위한 자동 레이저 솔더링 설비로, 특히 태양광 모듈에 적합합니다.
SB² ® – SM
SB² ® - SM은 프로토타입 제작 및 소량 생산을 위한 장비로, SB² ® - M보다 넓은 작업 영역과 더 다양한 선택 기능을 제공합니다.
LAPLACE ® – LAB 300A
LAPLACE ® - LAB 300A는 레이저 어시스트 솔더링, ACF 및 NCP 인터커넥션을 통한 플립칩 조립의 통합 솔루션을 제공합니다.
LAPLACE ® – LAR 600A
The LAPLACE ® LAR 600A 는 레이저 어시스트 기술을 적용하여 리플로우 솔더링 방식을 혁신합니다. 더 짧은 리플로우 시간, 낮은 열 스트레스, 향상된 효율성을 다양한 응용 분야에 제공하며, 에너지 소비와 CO₂ 배출을 최소화합니다.