BGA 상 결함이 있는 솔더 볼 수리를 위한 리볼링/디볼링
경우에 따라 반도체 장치의 결함이 있는 솔더 접점을 수리해야하는 경우가 있을 수 있습니다. PacTech은 다른 관점에서 접근하는 방법을 제공합니다.
수리
수리 작업은 리플로우 공정 전에 범핑을 진행할 때 패드에서 누락 또는 중첩된 솔더볼에 대해 수행합니다. 수율 손실은 페이스트 프린팅, 솔더 페이스트 디스펜싱, 단일 혹은 복수의 솔더볼 마운팅 단계 어디에서나 일어날 수 있습니다. 대부분의 제품 생산에서 수율 손실은 이윤 감소로 이어지며, 입출력(I/O) 수가 많은 고부가가치 제품일수록 그 영향이 큽니다. 인라인 수리 스테이션을 사용하여 과도한 솔더볼을 제거하고 누락된 패드 위치에 솔더볼을 다시 배치해 주면, 마운팅 수율은 비약적으로 향상되고 더 효율적인 리플로우 결과를 가져옵니다.
리워크
반도체 제품인 볼 그리드 어레이(BGA), 칩 스케일 패키지(CSP), 또는 플립 칩 패키지(FC)의 조립 과정에서 부품이 손상될 경우, 솔더 범프를 리워크하는 작업이 필요합니다. 이러한 디바이스를 리워크하려면 개별 부품의 분해 작업이 필요합니다. 여기에는 디바이스와 기판에서 손상된 솔더 범프를 제거하고 새로운 범프로 교체하는 작업이 포함됩니다. 유연한 리워크 장비는 이러한 부품들을 처리할 수 있어 전체 시스템 수율을 크게 향상시킬 수 있습니다.
리볼링/디볼링
특수한 용도로 인해 무연 볼을 유연 볼로 교체해야 할 경우, 이 공정은 ‘리볼링(Reballing)’이라고 합니다. 대부분의 BGA 후단 패키징 업체들은 무연 합금(SnAgCu)으로 전환하여, 국방·항공우주·의료 등 특수 응용 분야에서 요구되는 납 함유 BGA를 사용할 수 없게 되었습니다.
재작업(Rework) 및 리볼링/디볼링(Reballing/Deballing) 공정 (확장하여 수리도 포함)은 당사의 SB² ® 레이저 기반 범핑 시스템으로 수행할 수 있습니다. 이 시스템은 국소 가열원을 이용해 단일 솔더 범핑을 선택적으로 녹인 후, 진공을 사용하여 웨이퍼, 칩 또는 패키지와 같은 장치에서 용융된 솔더 재료를 제거하고 교체합니다. SB² ® 시스템은 사전에 성형된 새 솔더볼을 패드 위에 떨어뜨리면서, PacTech의 Solder Jetting 공정을 통해 리플로우를 동시에 진행합니다.
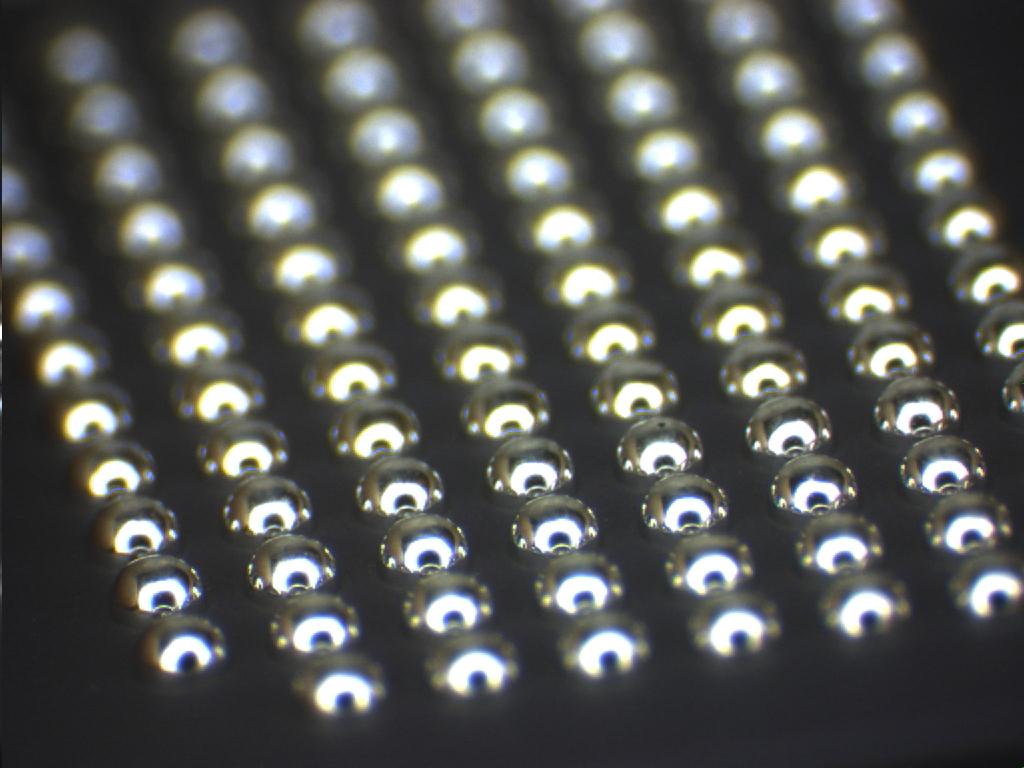
솔더 볼 리워크 설비
SB² ® – Compact
SB² ® - Compact 장비는 고도로 유연하고 초소형 워크스테이션을 갖춘 대량 생산용 SB² ® 시리즈의 입문형 설비입니다.
SB² ® – SM
SB² ® - SM은 프로토타입 제작 및 소량 생산을 위한 장비로, SB² ® - M보다 넓은 작업 영역과 더 다양한 선택 기능을 제공합니다.
SB² ® – Jet
SB² ® - Jet은 PacTech의 SB² ® 시리즈 중 가장 높은 배치 정밀도를 제공하며, 가장 작은 솔더 볼까지 처리할 수 있습니다.